csp与wlcsp 内存封装颗粒csp与bga的区别
2021-09-10 20:45:25
来源:朵拉利品网
1, 内存封装颗粒csp与bga的区别
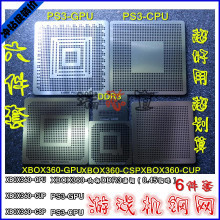
1、意思不同:CSP(Chip Scale Package)封装是芯片级封装。BGA (Ball Grid Array)是高密度表面装配封装技术。2、产品特点不同:CSP产品特点是体积小。BGA产品特点是高密度表面装配。3、名称不同:CSP的中文名称是CSP封装。BGA的中文名称是BGA封装技术。CSP的特点:1、体积小,在各种封装中,CSP是面积最小,厚度最小,因而是体积最小的封装。2、输入/输出端数可以很多,在相同尺寸的各类封装中,CSP的输入/输出端数可以做得更多。3、电性能好,CSP内部的芯片与封装外壳布线间的互连线的长度比QFP或BGA短得多,因而寄生参数小,信号传输延迟时间短,有利于改善电路的高频性能。4、热性能好,CSP很薄,芯片产生的热可以很短的通道传到外界。5、CSP不仅体积小,而且重量轻。参考资料来源:百度百科-BGA封装技术参考资料来源:百度百科-CSP封装
4, wlcsp封装技术和wlp先进封装有什么不同
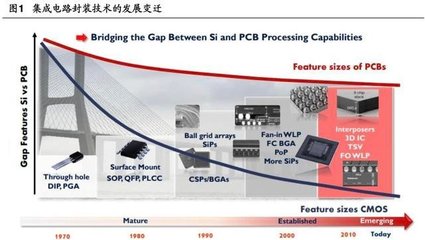
A B DCSP封装可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,绝对尺寸也仅有32平方毫米,约为普通的BGA的1/3,仅仅相当于TSOP内存芯片面积的1/6。这样在相同体积下,内存条可以装入更多的芯片,从而增大单条容量。也就是说,与BGA封装相比,同等空间下CSP封装可以将存储容量提高三倍。CSP封装内存不但体积小,同时也更薄,其金属基板到散热体的最有效散热路径仅有0.2mm,大大提高了内存芯片在长时间运行后的可靠性,线路阻抗显著减小,芯片速度也随之得到大幅度的提高。CSP封装的电气性能和可靠性也相比BGA、TOSP有相当大的提高。在相同的芯片面积下CSP所能达到的引脚数明显的要比TSOP、BGA引脚数多的多(TSOP最多304根,BGA以600根为限,CSP原则上可以制造1000根),这样它可支持I/O端口的数目就增加了很多。此外,CSP封装内存芯片的中心引脚形式有效的缩短了信号的传导距离,其衰减随之减少,芯片的抗干扰、抗噪性能也能得到大幅提升,这也使得CSP的存取时间比BGA改善15%-20%。在CSP的封装方式中,内存颗粒是通过一个个锡球焊接在PCB板上,由于焊点和PCB板的接触面积较大,所以内存芯片在运行中所产生的热量可以很容易地传导到PCB板上并散发出去;而传统的TSOP封装方式中,内存芯片是通过芯片引脚焊在PCB板上的,焊点和PCB板的接触面积较小,使得芯片向PCB板传热就相对困难。CSP封装可以从背面散热,且热效率良好,CSP的热阻为35℃/W,而TSOP热阻40℃/W。测试结果显示,运用CSP封装的内存可使传导到PCB板上的热量高达88.4%,而TSOP内存中传导到PCB板上的热量能为71.3%。另外由于CSP芯片结构紧凑,电路冗余度低,因此它也省去了很多不必要的电功率消耗,致使芯片耗电量和工作温度相对降低。目前内存颗粒厂在制造DDR333和DDR400内存的时候均采用0.175微米制造工艺,良品率比较低。而如果将制造工艺提升到0.15甚至0.13微米的话,良品率将大大提高。而要达到这种工艺水平,采用CSP封装方式则是不可避免的。因此CSP封装的高性能内存是大势所趋。
名词解释
封装
封装,Package,是把集成电路装配为芯片最终产品的过程,简单地说,就是把铸造厂生产出来的集成电路裸片(Die)放在一块起到承载作用的基板上,把管脚引出来,然后固定包装成为一个整体。 作为动词,“封装”强调的是安放、固定、密封、引线的过程和动作;作为名词,“封装”主要关注封装的形式、类别,基底和外壳、引线的材料,强调其保护芯片、增强电热性能、方便整机装配的重要作用。
WLCSP
晶圆片级芯片规模封装(Wafer Level Chip Scale Packaging,简称WLCSP),即晶圆级芯片封装方式,不同于传统的芯片封装方式(先切割再封测,而封装后至少增加原芯片20%的体积),此种最新技术是先在整片晶圆上进行封装和测试,然后才切割成一个个的IC颗粒,因此封装后的体积即等同IC裸晶的原尺寸。
芯片
集成电路(英语:integrated circuit,缩写作 IC),或称微电路(microcircuit)、微芯片(microchip)、晶片/芯片(chip)在电子学中是一种把电路(主要包括半导体设备,也包括被动组件等)小型化的方式,并时常制造在半导体晶圆表面上。
相关资讯
相关产品
最新资讯
相关企业
